F3-sX系列
标签: 近红外,单点测试
发布时间: 2019-04-17 14:50:54发布
F3-sX系列使用近红外光来测量薄膜厚度,F3-s980 是波长为980奈米的版本,是为了针对成本敏锐的应用而设计,F3-s1310是针对重掺杂硅片的最佳化设计,F3-s1550则是为了最厚的薄膜设计。
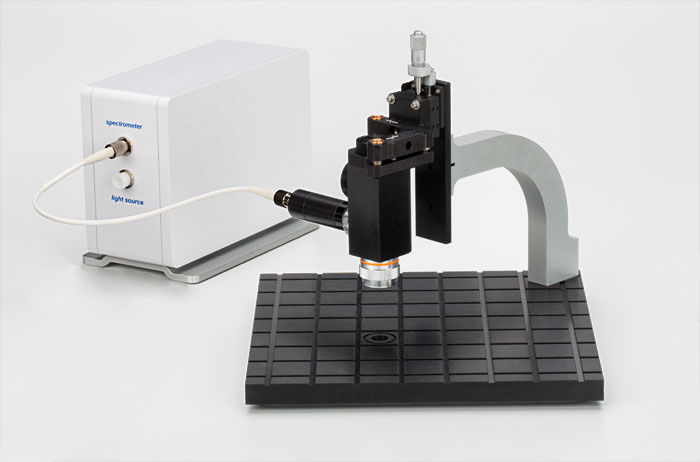
F3-sX 系列能测量半导体与介电层薄膜厚度到3毫米,而这种较厚的薄膜与较薄的薄膜相比往往粗糙且均匀度较为不佳。
波长选配
F3-sX系列使用近红外光来测量薄膜厚度,即使有许多肉眼看来不透光(例如半导体)。 F3-s980 是波长为980奈米的版本,是为了针对成本敏锐的应用而设计,F3-s1310是针对重掺杂硅片的最佳化设计,F3-s1550则是为了最厚的薄膜设计。
产品链接:http://www.ilabilab.com/goods.php?id=7137
邮箱:ilabmarket@ilabilab.com
手机/WeChat:18917564620 (吕经理)
应用实例:
1.集成电路故障分析
故障分析 (FA) 技术用来寻找并确定集成电路内的故障原因。
故障分析中需要进行薄膜厚度测量的两种主要类型是正面去层(用于传统的面朝上的电路封装) 和背面薄化(用于较新的覆晶技术正面朝下的电路封装)。
正面去层
正面去层的工艺需要了解电介质薄化后剩余电介质的厚度。
背面故障分析
背面故障分析需要在电路系统成像前移除大部分硅晶粒的厚度,并了解在每个薄化步骤后剩余的硅厚度是相当关键的。 Filmetrics F3-sX是为了测量在不同的背面薄化过程的硅层厚度而专门设计的系统。 厚度从5微米到1000微米能够很容易的测量,另外可选配模组来延伸最小测量厚度至0.1微米,同时具有单点和多点测绘的版本可供选择。
测量范例
現在我們使用我們的 F3-s1550 系统测量在不同的背面薄化过程的硅层厚度.具備特殊光學設計之 F3-S1550利用比直徑更小於10μm的光斑尺寸得以測量拋光以及粗糙或不均勻表面的硅层厚度。

2.硅晶圆薄膜
Filmetrics 提供台式系统, 测绘, 和生产测量 1nm 到 2mm 硅晶片和膜厚仪器系统。
